Laboratoire d’analyse ToF-SIMS
Vos besoins : caractériser la composition chimique d'extrême surface d'un échantillon par une analyse TOF-SIMS
TOF SIMS, un moyen technique de pointe
Le Spectromètre de Masse d’Ions Secondaires à temps de vol (ToF-SIMS en anglais pour Time-of-Flight Secondary Ion Mass Spectrometry), sims analysis en anglais, est une technique d’imagerie et d’analyse permettant d’obtenir des informations élémentaires et moléculaires sur les espèces présentes en extrême surface d’échantillons à l’état solide.
Analyse TOF SIMS
L’analyse par TOF SIMS est une technique de pointe, offrant une sensibilité et une résolution moléculaire élevée dans le cadre de l’analyse d’extrême surface et de l’étude des compositions chimiques des matériaux.
L’analyse TOF-SIMS fournit des informations qualitatives et semi-quantitatives sur les éléments et molécules présents.
De plus, c’est une technique d’imagerie à haute résolution qui permet de cartographier la distribution des éléments et des molécules à la surface d’un échantillon avec une résolution spatiale élevée.
Cette capacité permet au laboratoire FILAB de comprendre les hétérogénéités de la surface et les interfaces matérielles.
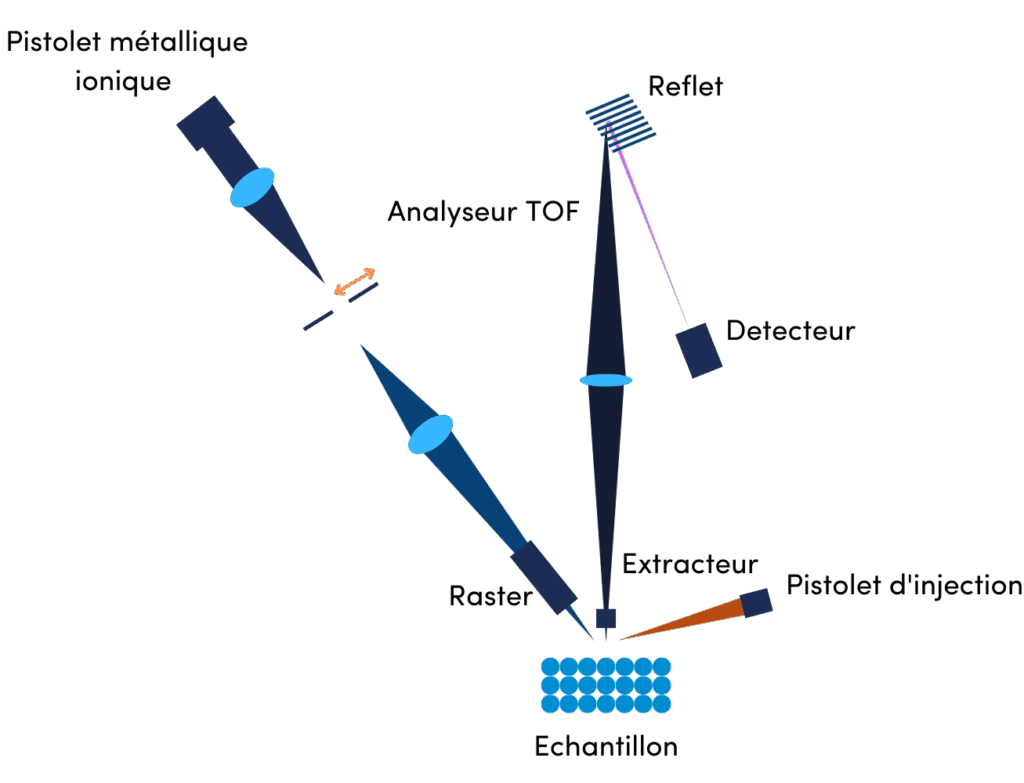
Nos solutions : proposer les techniques d'analyses TOF-SIMS spécifiques à vos demandes et fournir des résultats rapides et fiables
Pourquoi choisir FILAB pour une analyse tof-sims ?
Le laboratoire FILAB est spécialisé en analyses TOF-SIMS, dans le cadre de l’étude de la composition chimique et moléculaire des surfaces de matériaux. Adaptés aux secteurs allant de la microélectronique à la biotechnologie, nous combinons expertise en analyse d’extrême surface et technologie de pointe avec le TOF SIMS pour fournir des résultats précis et fiables, à l’échelle nanométrique. Découvrez comment nos analyses TOF-SIMS peuvent contribuer à la réussite de vos projets garantissant la qualité et l’innovation.
Nos prestations d’analyses par TOF SIMS
L’analyse ou l’expertise par ToF SIMS de la composition chimique élémentaire et moléculaire d’extrême surface d’un échantillon peut être mise en œuvre dans différents contextes :
Caractérisation chimique de surface pour la R&D et l’optimisation de procédés
Étude comparative entre différents traitements ou formulations
Détermination du taux de réticulation d’un polymère plasma (évaluation de la fonctionnalisation de surface)
Étude de faisabilité pour la mise en place d’un process ou d’un revêtement
Différenciation de la chimie du silicium (Si) selon les états d’oxydation ou les traitements subis
Analyse de contamination et diagnostic de surface
Identification d'une pollution ou dépôt en surface d’un matériau (diagnostic élémentaire et moléculaire)
Délamination d’une peinture (analyse de l’interface de rupture)
Décoloration de peinture (recherche de contaminants ou altérations chimiques)
Analyse de particule (caractérisation chimique localisée d’une inclusion ou dépôt)
Vérification fonctionnelle des surfaces
Détection de tous les éléments jusqu’au ppm (traces de contaminants ou additifs)
Vérification de la fonction de surface d’un produit en lien avec ses performances d’adhérence ou d’accroche mécanique
Analyse qualitative pour s’assurer de la présence ou de l’absence de certains composés chimiques fonctionnels
Études de matériaux multicouches et profilage en profondeur
Analyse multicouche (composition, épaisseur, séquence des couches fines)
Profiler un échantillon organique avec faisceau d’agrégat d’argon, permettant le maintien de l’information moléculaire en profondeur (jusqu’à 3 à 10 µm max)
Analyse élémentaire et moléculaire haute résolution
Identification atomique et moléculaire sur une large gamme de masses (de 0 à 10 000 uma)
Analyse isotopique pour différencier des isotopes d’un même élément ou tracer des marquages spécifiques
Et aussi...
Les applications industrielles de la technique TOF-SIMS
Les analyses TOF-SIMS sont sollicitées dans diverses industries pour leurs capacités à caractériser la composition chimique de surfaces avec une grande sensibilité et résolution.
Dans l’industrie des semi-conducteur, cette technique permet de contrôler la puretédes matériaux et la structure des dispositifs, affectant directement la performance et la fiabilité des composants électroniques.
Les industries pharmaceutiques tirent également parti de la TOF-SIMS pour des analyses de , entre les surfaces des dispositifs médicauxet l’environnement biologique.
Dans le domaine de la recherche en matériaux, la TOF SIMS permet de comprendre les propriétés de surface des nouveaux matériaux composites, avec des propriétés ciblées.
Dans le domaine de l’énergie, cette technique permet de réaliser l’analyse des matériaux pour les batteries et les panneaux solaires
La sensibilité de surface de l'analyse tof-sims
Matériaux et surfaces concernés
Cette technique peut être appliquée à une grande variété de matériaux, y compris les polymères, les matériaux métalliques, les céramiques/a>, et les matériaux composites, les films, le verre et fibre de verre, implants dentaires, … sans nécessiter une préparation complexe d’échantillons.
Tous les matériaux conducteurs et isolants, stables sous ultra haut vide peuvent être analysés par ToF-SIMS : métaux, alliages, semi-conducteurs, polymères, ivernis, peintures, adhésifs, additifs, tensioactifs, céramiques, verre, bois, papier, textiles, ultra-vide, dépôts minces…
Pourquoi réaliser une analyse TOF SIMS en laboratoire ?
L’analyse TOF SIMS est particulièrement valorisée pour sa capacité à fournir des informations détaillées sur la composition chimique élémentaire tant en surface qu’en profondeur des matériaux (jusqu’à 1nm).
Elle permet non seulement d’examiner la surface pour identifier les éléments et molécules présents, mais aussi de réaliser des profils de profondeur en éliminant progressivement des couches, ce qui révèle les variations compositionnelles à différents niveaux. Ainsi, cette technique se distingue par sa capacité à identifier la structure moléculaire des composés.
Incontournable pour l’étude de surface, cette double capacité d’analyse, spatial et moléculaire, rend l’analyse TOF SIMS incontournable pour l’étude de surface, l’étude des interactions entre matériaux, la compréhension de la présence de corrosion, l’analyse des revêtements et bien d’autres applications.
FAQ
L'analyse d'extrême surface par TOF-SIMS implique d'abord la préparation de l'échantillon, suivi de son introduction dans la chambre à vide du spectromètre. Un faisceau d'ions primaires bombarde la surface, libérant des ions secondaires qui sont ensuite identifiés par leur temps de vol, permettant ainsi de déterminer la composition chimique de la surface.
Son principe consiste à bombarder via une source pulsée d’ions primaires (Ga+, Bin+, Au+, C60+, …) la surface à analyser afin de produire des ions secondaires depuis les premières couches monoatomiques de l’échantillon. Ces derniers ions, qu’ils soient positifs ou négatifs, sont ensuite focalisés et accélérés dans un analyseur à temps de vol au sein duquel leurs temps de parcours est fonction de leurs masses. En couplant à un dispositif de balayage du faisceau d’ions primaires, on obtient ainsi une cartographie des différents éléments chimiques et espèces moléculaires en surface de l’échantillon.
La TOF-SIMS peut détecter des éléments à des concentrations extrêmement faibles, jusqu'à des niveaux de quelques parties par million (ppm), en fonction de la matrice de l'échantillon et des conditions expérimentales.
Lors d’une analyse SIMS statique, un faisceau primaire pulsé cible uniquement la première monocouche de l’échantillon.
Contrairement à l’analyse SIMS dynamique, cette approche préserve l’intégrité moléculaire de la surface. Les molécules sont simplement désorbées ou fragmentées en plusieurs morceaux. Les ions secondaires, constitués de fragments des molécules initiales, sont ensuite détectés par un spectromètre à temps de vol. Des ions moléculaires pesant jusqu’à 10 000 uma peuvent être identifiés, fournissant ainsi des informations détaillées sur la structure moléculaire des composés organiques.
L'analyse SIMS est une technique de laboratoire qui permet de déterminer la composition d'un matériau en bombardant sa surface avec des ions. Ce bombardement libère des particules de la surface du matériau, qui sont ensuite analysées pour identifier les éléments chimiques et leurs quantités. Cette méthode est très précise mais destructive, en effet elle permet de détecter de très petites quantités et peut endommager l'échantillon.
La TOF-SIMS (Time-of-Flight Secondary Ion Mass Spectrometry) est une forme avancée de l’analyse SIMS. Elle utilise un analyseur à temps de vol, qui mesure la masse des ions secondaires en fonction de leur temps de parcours. Cette technique offre une résolution de masse très élevée, permet de détecter simultanément un grand nombre d’espèces chimiques, et est particulièrement adaptée pour les analyses qualitatives, cartographiques ou encore le profilage en profondeur sur des matériaux complexes (multicouches, organiques, contaminations…).
Le mode SIM (Selected Ion Monitoring) en spectrométrie de masse consiste à ne suivre qu’un nombre restreint d’ions prédéfinis, plutôt que d’analyser l’ensemble du spectre de masse. Ce mode permet d’augmenter la sensibilité et la spécificité de l’analyse pour certains composés cibles. Il est particulièrement utile lorsque l’on souhaite détecter ou quantifier des substances connues, même à très faibles concentrations.
L’analyse TOF-SIMS permet d’identifier des traces de contamination, de caractériser des couches minces ou d’étudier l’homogénéité chimique de surfaces critiques. Elle est particulièrement utile dans les secteurs où la qualité de surface influence directement la performance du produit : microélectronique, biomatériaux, revêtements techniques, etc.
Une contamination, même à l’état de traces, peut altérer l’adhérence d’un revêtement, provoquer une corrosion prématurée, perturber une réaction chimique ou générer des défauts de fabrication. L’analyse TOF-SIMS permet de localiser et d’identifier précisément ces contaminants.
Oui, le TOF-SIMS est un outil clé dans les investigations de non-conformité. Elle permet d’analyser des zones très localisées, comme des fissures, bulles, délaminations ou interfaces défectueuses, pour en comprendre la cause chimique.
Parfaitement. L’analyse TOF-SIMS permet un profilage en profondeur (depth profiling) avec une résolution nanométrique, idéale pour caractériser l’épaisseur, la composition et l’ordre des couches dans des systèmes multicouches.
TOF-SIMS est l’une des techniques d’analyse de surface les plus sensibles : elle permet de détecter des concentrations à l’échelle du ppm (parties par million), voire plus bas, sur les premiers nanomètres d’un matériau.
TOF-SIMS peut analyser des zones extrêmement réduites, jusqu’à quelques microns carrés, ce qui en fait une méthode idéale pour les études localisées ou sur des défauts précis.
Oui. Contrairement à d’autres techniques, la TOF-SIMS statique permet de préserver des fragments moléculaires organiques, rendant possible l’identification de polymères, lubrifiants, additifs, résidus biologiques ou autres composés organiques.
L’analyse SIMS regroupe différentes techniques de spectrométrie de masse par ions secondaires. La TOF-SIMS (Time-of-Flight SIMS) utilise un analyseur à temps de vol, qui permet une haute résolution de masse et une détection simultanée de tous les ions secondaires, idéale pour des analyses qualitatives et cartographiques très détaillées.
La TOF-SIMS peut intervenir à différents stades :
– En R&D, pour caractériser de nouveaux matériaux ou valider un procédé de dépôt ;
– En phase de production, pour contrôler la conformité de surface ;
– En post-mortem, pour analyser une défaillance ou un défaut qualité.









